
掃碼添加微信,獲取更多半導(dǎo)體相關(guān)資料
? ? ? 氫氧化鉀(KOH)是一種用于各向異性濕法蝕刻技術(shù)的堿金屬氫氧化物���,是用于微加工硅片的最常用的硅蝕刻化學(xué)物質(zhì)之一�����。各向異性蝕刻優(yōu)先侵蝕基底�����。也就是說(shuō)��,它們?cè)谀承┓较蛏系奈g刻速率比在其他方向上的蝕刻速率高����,而各向同性蝕刻(如高頻)會(huì)在所有方向上進(jìn)行��。使用氫氧化鉀工藝是因?yàn)樗谥圃熘械目芍貜?fù)性和均勻性�����,同時(shí)保持低生產(chǎn)成本��。異丙醇(IPA)經(jīng)常被添加到溶液中���,以改變從{110}壁到{100}壁的選擇性,并提高表面光滑度���。
? ? ? 使用氫氧化鉀蝕刻有一些缺點(diǎn)���。最大的問(wèn)題是蝕刻過(guò)程中H2氣泡的產(chǎn)生��。這些H2泡沫充當(dāng)了一個(gè)假面具�����。這增加了粗糙度���,并可能損壞微結(jié)構(gòu)。與氫氧化鉀蝕刻相關(guān)的另一個(gè)問(wèn)題是氫氧化鉀含有堿離子�����。KOH是MOS器件的終身殺手���。至關(guān)重要的是���,那些使用氫氧化鉀的人要小心不要污染任何其他工藝。氫氧化鉀還會(huì)腐蝕鋁�����,這可能是片上電路的一個(gè)問(wèn)題����。
?
堿性氫氧化鉀蝕刻特性
? ? ? 氫氧化鉀蝕刻的蝕刻速率受硅晶體取向的嚴(yán)重影響。這是因?yàn)樗母飨虍愋浴?/span>圖1為70?C下的氫氧化鉀濃度���。括號(hào)內(nèi)的數(shù)字是相對(duì)于(110)的標(biāo)準(zhǔn)化值���。
?
圖1 不同晶體取向和氫氧化鉀濃度的硅刻蝕率
? ? ? (110)平面是最快的蝕刻主表面,而(111)平面是迄今為止最慢的蝕刻平面�����。這被認(rèn)為是由于理想的(110)表面具有比(100)和(111)主表面更不均勻的原子結(jié)構(gòu)�����;而(111)是緊密堆積的����,每個(gè)原子只有一個(gè)懸掛鍵,總體上原子級(jí)平坦�。
?
氫氧化鉀蝕刻速率與成分和溫度的關(guān)系?
? ? ? 蝕刻速率隨著溫度的升高而增加;然而�����,隨著蝕刻速率的增加�����,會(huì)導(dǎo)致不太理想的蝕刻行為�����。當(dāng)氫氧化鉀濃度增加超過(guò)18wt%時(shí)��,蝕刻速率降低����。這是因?yàn)榘l(fā)生了蝕刻反應(yīng)。當(dāng)強(qiáng)堿�,如氫氧化鉀(含有豐富的氫氧離子)存在時(shí),硅-硅鍵斷裂�。這種蝕刻導(dǎo)致Si(OH)4的形成、四個(gè)水分子的消耗和兩個(gè)氫氣分子的釋放���。隨著溶液中水含量的降低��,反應(yīng)受到限制�。圖2是硅取向與成分百分比�����、溫度和取向相關(guān)的蝕刻率。
?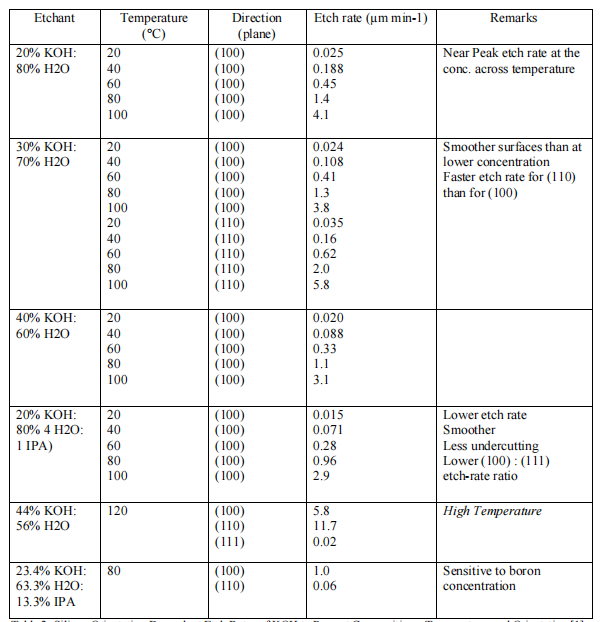
圖2 硅取向-氫氧化鉀的依賴性蝕刻率與成分����、溫度和取向的百分比
KOH
? ? ? 在(100)硅上的晶片平面上與<110>方向?qū)R的矩形開(kāi)口導(dǎo)致暴露的{100}平面蝕刻迅速,而{111}平面蝕刻緩慢���。結(jié)果�����,{111}平面顯示�,與晶圓平面形成54.7°角���。隨著蝕刻的繼續(xù)��,{111}飛機(jī)最終將相遇���,創(chuàng)造一個(gè)“V”凹槽。蝕刻不是零����,所以確實(shí)會(huì)發(fā)生一些切割�。一個(gè)類似于矩形掩模對(duì)齊的正方形掩模將導(dǎo)致一個(gè)金字塔形的坑�。
? ? ? KOH各向異性蝕刻的另一個(gè)特征是掩模上有凸角。當(dāng)掩模具有凸起的拐角時(shí)�,構(gòu)成拐角的{111}平面被蝕刻掉���。如果允許該蝕刻完成����,掩模層被完全底切����,并且掩模被留在“V”形槽坑上方�。根據(jù)圣圖里亞的說(shuō)法,對(duì)此可能的解釋是{111}面通常有一個(gè)懸掛的表面原子鍵�����。在兩個(gè){111}面相交的拐角處��,必須存在兩個(gè)懸空鍵����。這些被蝕刻掉���,導(dǎo)致其他快速蝕刻平面暴露出來(lái)。
? ? ? 對(duì)此��,一個(gè)可能的解釋是�,{111}平面通常有一個(gè)懸掛的表面原子鍵。在兩架飛機(jī)相遇的角落��,必須有兩個(gè)懸掛的鍵��。這些被蝕刻掉��,導(dǎo)致其他快速蝕刻的平面被暴露出來(lái)��。
? ? ? 這種下切割特征也存在于其他形狀中�。例如,蝕刻橢圓掩模產(chǎn)生一個(gè)矩形v凹坑��,其邊緣與<110>方向?qū)R��。由于這種不足��,可能會(huì)發(fā)生許多關(guān)于掩碼對(duì)齊的問(wèn)題���。一個(gè)非常小的旋轉(zhuǎn)誤差可以導(dǎo)致特征被削弱和大大擴(kuò)大的�。
? ? ? 氫氧化鉀蝕刻通常使用三種掩模材料——氮化硅、二氧化硅和硼摻雜(磷+)硅��。氮化硅在氫氧化鉀中幾乎不蝕刻�,二氧化硅在85℃的20重量%氫氧化鉀中以大約1.4納米/分鐘的速率蝕刻,并且p+硅根據(jù)蝕刻劑濃度和溫度給出10∶1到100∶1之間的蝕刻減少�。