
掃碼添加微信�����,獲取更多半導體相關資料
引言
小結構的清洗和沖洗是微電子和納米電子制造中的重要過程�。最新技術使用“單晶片旋轉清洗”����,將超純水(UPW)引入到安裝在旋轉支架上的晶片上。這是一個復雜的過程���,其降低水和能源使用的優(yōu)化需要更好地理解過程的基本原理。本文提出了一個數(shù)學模型,它使用了基本的物理機制并提供了一個綜合的過程模擬器����。該模型包括流體流動,靜電效應�����,以及整體和表面的相互作用���。該模擬器被應用于研究具有鉿基高k微米和納米結構的圖案化晶片的清洗動力學的特定情況�。研究了關鍵清洗工藝參數(shù)的影響�,例如水流速度��、晶片旋轉速度�����、水溫���、晶片尺寸和晶片中的溝槽位置����。在表面處理過程的設計和控制中成功地結合這種沖洗模擬器將消除對更昂貴和更費時的外部分析技術的依賴��。
半導體和其它納米尺寸器件制造順序中的一個關鍵步驟是在襯底(例如硅或介電層)被圖案化和蝕刻后清潔小結構����。圖案化晶片的清洗和沖洗是繼許多其它制造步驟之后最常用的工藝。在整個制造過程中����,它也是最大的用水單位,半導體制造廠的用水量超過60%[2]��。所有現(xiàn)代工廠現(xiàn)在都使用旋轉清洗和沖洗設備,其中超純水(UPW)被引入到安裝在旋轉支架上的晶片上�。多個過程,如解吸和再吸附�����、擴散��、遷移和對流��,都是這個沖洗過程及其潛在瓶頸的因素���。這些過程中的任何一個都可能成為漂洗過程的限速步驟或瓶頸�。對圖案化晶片的旋轉清洗的基本原理知之甚少�。確保漂洗過程中的最佳資源利用和周期時間需要對過程基本原理有充分的了解。
對于高k電介質等新材料�,表面相互作用的數(shù)據(jù)至關重要�。
旋轉圓盤上的流體流動和質量傳遞一直是許多研究的主題。本文還 研究了旋轉圓盤上薄液膜流動的流體動力學����。 ?將注意力集中在作為連續(xù)流運行的旋轉圓盤上,其中流動的平均性質在時間上是穩(wěn)定的�����。使用旋轉圓盤幾何學來研究傳質在苯甲酸在靜止液體中的溶解中的作用�����。集中于使用粒子圖像測速儀確定旋轉晶片上的流動模式和速度����。這些例子和其他先前工作的焦點是在旋轉盤上方的流體膜中的流體流動和質量傳遞���。轉盤系統(tǒng)的這一方面雖然重要����,但不是本研究的目標或重點。
這里正在研究的問題是存在于旋轉圖案化的水中的納米結構的清潔機理���。圖案化的晶片不是平面盤���,并且其清洗的瓶頸不是盤上方的流體層中和其頂面上的流體流動和質量傳遞。這項工作的重點是將雜質從高縱橫比(深)的納米和微米結構中轉移出來�����,這些結構是通過構圖工藝在這些晶片中蝕刻出來的����。旋轉頂層的流體力學和傳質disk集成了發(fā)生在這些結構內(nèi)部的輸運�、電場、表面電荷和表面吸附/解吸過程的詳細方程�����。這些在處理圖案化晶片時至關重要的方面��,到目前為止還沒有被研究。由于漂洗過程本質上處于不穩(wěn)定狀態(tài)����,因此沒有研究的過程的其他方面是由于表面電荷產(chǎn)生的電場對微結構和納米結構內(nèi)的質量傳遞的臨界效應以及該瞬態(tài)過程的動力學。
本研究選擇的具體案例是從氧化鉿襯底上去除殘留的HF�。這種組合與鉿基電介質在半導體制造中的最新廣泛應用非常相關。通過使用這些測試材料發(fā)現(xiàn)的相互作用參數(shù)對于從事高k處理的研究人員將是非常有價值的����。在我們之前的研究中[3,4]我們報道了HF與氧化鉿的相互作用參數(shù)。本工作中的方法和過程模擬結果適用于所有的襯底和雜質����。此外,這些結果的應用并不局限于半導體制造���,還可用于制造光電子學和微流體元件中的其他納米結構���。
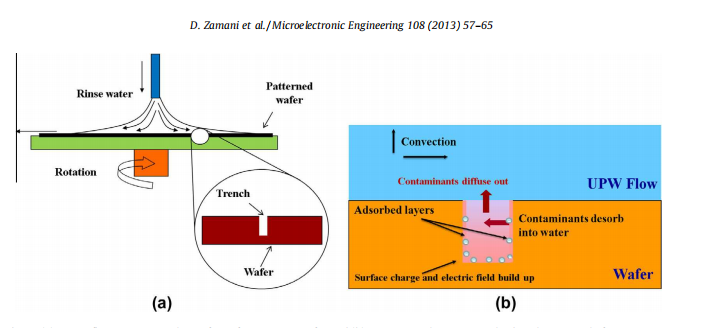
圖一?(a)旋轉晶片表面上的水流模式,以及(b)涉及去除污染物的各種機制
?
結果和討論
5.1.模型驗證
為了驗證工藝模型�����,我們進行了特殊的漂洗實驗����,首先將帶有圖案氧化鉿表面層的晶片暴露在高頻溶液中清洗��,然后用超純水沖洗�����。晶片模式包括用于沖洗監(jiān)測的ECRS通道�����。利用傳感器阻抗測量能力監(jiān)測傳感器通道的沖洗���。實驗數(shù)據(jù)與1:100(100/rin轉速和1.2l/min)后沖洗的模型預測的比較,如圖3所示���。該圖顯示了一個4毫米寬�、2毫米深的微通道內(nèi)溶液的阻抗��。在這種情況下����,模型與輪廓的良好擬合給出了參數(shù)的大小�,并證實了模型公式的有效性����。高頻處理的工藝參數(shù)見表1��。
?
5.2.模型預測
采用過程仿真方法研究了操作參數(shù)對沖洗動力學的影響��。
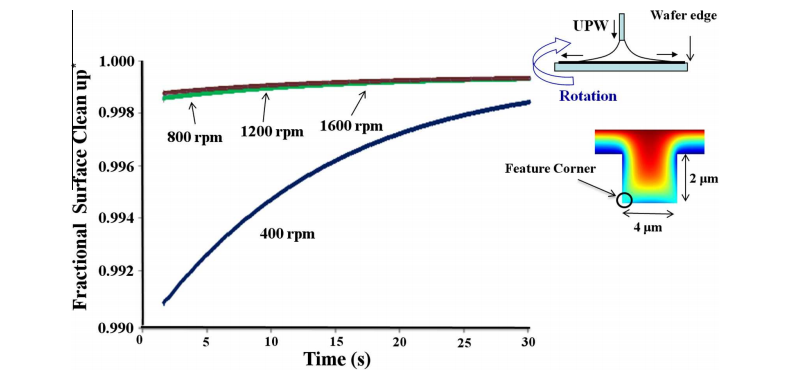
圖4 轉速對漂洗效率的影響

圖5 流量對漂洗效率的影響
?
結論
開發(fā)了用于研究單晶片旋轉清洗工具中清洗和清潔動力學的綜合工藝模型�,并將其應用于鉿基圖案化襯底的清洗。過程模擬器考慮了離子的吸附�����、解吸�、傳導、擴散����、遷移和表面電荷。研究了關鍵清洗工藝參數(shù)的影響���,如水流速度、晶片旋轉速度����、水溫�����、晶片尺寸和晶片上的溝槽位置�。發(fā)現(xiàn)較高的水流速度和較高的晶片旋轉速度有助于漂洗過程����。