
掃碼添加微信����,獲取更多半導(dǎo)體相關(guān)資料
本文介紹了抗蝕劑工藝的基礎(chǔ)知識(shí)�,包括實(shí)用技術(shù)��,接近模式是一種具有成本效益的過程�����,具有實(shí)現(xiàn)任意2-3微米寬度模式的潛力�����,在解釋了標(biāo)準(zhǔn)過程和機(jī)制之后,描述了MEMS區(qū)域中的一些問題��。
光刻的基礎(chǔ)是基板面統(tǒng)一的并列處理����,與利用工具的機(jī)械加工相比�����,能夠越精細(xì)地增加制作裝置數(shù)量等,發(fā)揮包括生產(chǎn)率在內(nèi)的威力��,在MEMS領(lǐng)域中�����,在圖案化中,可能不是利用步進(jìn)器�����,而是利用對(duì)準(zhǔn)器的近距離曝光��,成本效益高�����,最小穩(wěn)定圖案寬度為2-3微米。
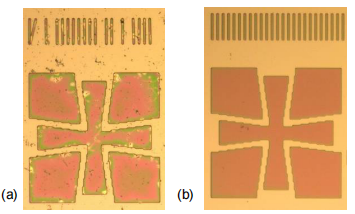
圖1
圖1是經(jīng)驗(yàn)少的學(xué)生利用OFPR-800LB光刻膠進(jìn)行圖案化的例子���,圖1(a)乍一看是壞的(1)整個(gè)基板上附有細(xì)小的垃圾��;(2)光刻膠顏色不均勻�,有漸變部分���;(3)上部提供間距為10微米的線-和-空間(占空比為1:1)�����,但5μm寬的線可能傾斜或丟失���。說明原因:(1)中的細(xì)小垃圾當(dāng)然應(yīng)該清除�����,將圓型晶片切割��,做成小芯片狀使用���,可以認(rèn)為是此時(shí)的垃圾,作為基板清洗����,學(xué)習(xí)使用食人魚溶液(硫酸和過氧化氫水)等強(qiáng)化學(xué)藥品進(jìn)行處理����。實(shí)際上���,在圖1(a)中進(jìn)行了該清潔處理�����,但是���,劃片中最有可能的垃圾是硅的碎片��。食人魚溶液對(duì)有機(jī)物有效,不能去除硅��。建議用有機(jī)溶劑和軟纖維����,如棉簽,機(jī)械擦拭�,擦拭的方向不要往復(fù)�����,以一定的方向?yàn)楹?���;?)和(3)是同樣的理由���,從細(xì)小的模式流動(dòng)可以推測(cè)���,模式轉(zhuǎn)錄本身已經(jīng)完成,但濕顯影處理發(fā)生了異常����,正抗蝕劑基本上與基板的粘合較弱��,當(dāng)成膜時(shí)�,抗蝕劑以液體狀態(tài)拉伸到基板上����,通過預(yù)焙����,稀釋劑脫落���,體積收縮,作為結(jié)構(gòu)材料考慮的話���,可以認(rèn)為是大的膜應(yīng)力在起作用。

圖2
圖2是很多教科書中介紹的光刻膠工藝一連串的工序����,預(yù)處理包括清潔和六甲基二硅烷(HMDS)處理,迅速地從硅表面除去水的多分子層并疏水化����。
圖3顯示了HMDS處理中產(chǎn)生的表面改性(1)�,HMDS與Si表面的OH反應(yīng)����,使表面成為疏水性�,實(shí)際上,在圖1(a)的例子中也使用了這種方法,在HMDS自旋涂覆后����,繼續(xù)自旋涂覆抗蝕劑,如果出現(xiàn)(2)(3)問題,建議在HMDS涂抹后高溫烘烤�����,如果沒有限制����,最好在200℃以上,HMDS分子分解·固定在基板上時(shí)����,作為表面活性劑發(fā)揮作用����,僅暴露于HMDS中時(shí)��,隨附生成的氨和未反應(yīng)的HMDS殘留在硅表面�,在270℃烘烤的物質(zhì)中,沒有確認(rèn)到這些物質(zhì)的存在����,抗蝕劑開始咬住基板,在為旋涂而滴下抗蝕劑時(shí)��,觀察到抗蝕劑難以擴(kuò)散的情況��,圖1(b)顯示了200℃烘烤措施����,良好的模式在有無抗蝕劑之間的差異很明顯�����,沒有中間色和暈染�。

圖3
綜上所述,可以理解抗蝕劑膜厚選擇的指針����,為了實(shí)現(xiàn)微細(xì)圖案�,基本是在允許的范圍內(nèi)使抗蝕劑膜變薄,當(dāng)抗蝕劑-基板之間的接觸面積相同且抗蝕劑膜變厚時(shí)�����,涂膜應(yīng)力的膜厚度積分值變大,因此容易剝離����,在MEMS特有的厚膜抗蝕劑中����,除了低附著力外�,還會(huì)出現(xiàn)裂紋�,這是共同的問題,主要是通過材料解決��,但也有處理上的注意點(diǎn)����,在將基板從高溫狀態(tài)中取出等情況下,通過導(dǎo)熱率低的材料等�����,避免陡峭的溫度變化引起的溫度沖擊�。
如果到成膜為止都正確進(jìn)行,那么決定解像度的第一件事就是曝光����,在微細(xì)圖案的轉(zhuǎn)錄中��,應(yīng)該意識(shí)到硬接觸���,這是因?yàn)榧词故俏⑿〉拈g隙�����,光強(qiáng)度分布也會(huì)隨著光傳播而與掩模的光強(qiáng)度分布發(fā)生變化����,厚膜抗蝕劑需要UV光的透射率高�,這是因?yàn)椋绻獠荒芡ㄟ^抗蝕劑層進(jìn)行吸收���,就無法形成圖案����,即使通過�,如果光刻膠的表面?zhèn)群突鍌?cè)的曝光量極端不同�����,圖案?jìng)?cè)壁也不會(huì)垂直。另外�,顯影通過顯影液從抗蝕劑表面?zhèn)冉佑|�,向基板依次進(jìn)行,表面?zhèn)冉佑|顯影液的時(shí)間越長(zhǎng)�,表面?zhèn)蕊@影時(shí)間越長(zhǎng)�����,對(duì)于曝光部分溶解的正型光刻膠����,表面?zhèn)鹊钠毓饬繜o論如何都較多且顯影時(shí)間也較長(zhǎng)�,表面?zhèn)热菀兹芙猓鍌?cè)難以溶解���。也就是說,側(cè)壁難以垂直����。相反��,對(duì)于曝光部分不溶的負(fù)型光刻膠,由于被強(qiáng)烈曝光而難以溶解的表面?zhèn)蕊@影時(shí)間較長(zhǎng)����,因此更具有溶解的條件�����,相互抵消而容易得到垂直壁�����,在用厚膜抗蝕劑形成垂直圖案時(shí)��,使用透過率高的負(fù)型抗蝕劑在原理上是有利的���。
通常����,抗蝕劑的適用性曝光量隨膜厚變化而變化���,SU-8不太受曝光量變化的影響�,這是因?yàn)閁V透過率高,在100μm左右的膜厚下��,UV吸收量不大���,當(dāng)膜厚較厚,需要精細(xì)圖案時(shí)�,應(yīng)同時(shí)使用顯影液槽的攪拌和超聲波處理�,但是,與微細(xì)圖案的倒下和剝落之間存在著權(quán)衡�����,干燥時(shí)產(chǎn)生的沖洗液的表面張力是主要原因,有時(shí)使用的不是表面張力為72kN/m的水�,而是24kN/m的叔丁醇50%水溶液。但是��,一般來說����,表面張力小的液體容易侵入抗蝕劑和基板的界面�����,容易引起圖案剝落��,雖然工藝變得復(fù)雜����,但如果使用利用升華的冷凍干燥法,表面張力幾乎可以降低為0�。
關(guān)于抗蝕劑過程����,介紹了通常很難在討論中出現(xiàn)的部分,由于近距離曝光本身很簡(jiǎn)單,所以對(duì)照原理�����,希望能為判斷提供參考�。