
掃碼添加微信��,獲取更多半導(dǎo)體相關(guān)資料
本文研究了化學(xué)預(yù)處理對硅表面質(zhì)量和紋理均勻性的影響,結(jié)果表明�����,為了更好的紋理均勻性�����,鋸晶片的初始硅表面應(yīng)處理以清除有機(jī)和金屬污染,然后去除有機(jī)溶劑痕跡并看到損壞的硅層蝕刻��,對光致發(fā)光衰減的額外測量證實(shí)了由a-si:H鈍化的紋理晶片的高質(zhì)量和均勻性����,本文研究了表面制備對硅片紋理均勻性的影響。
采用光學(xué)顯微鏡�、蔡司光學(xué)顯微鏡和光學(xué)CIS掃描儀進(jìn)行初級表面表征,表面掃描為所有樣品提供了相同的明亮和對比度設(shè)置����,為了揭示受損硅層的存在�,在紋理化100nm的a-Si:H后用牛津等離子體設(shè)備將其沉積在每個(gè)硅表面,然后進(jìn)行光致發(fā)光(PL)衰變測量���。此外�,硅中的PL衰減密切地反映了少數(shù)載流子的動力學(xué)�,可用于局部壽命值的估計(jì),采用圖2所示的實(shí)驗(yàn)裝置進(jìn)行了二維PL衰減時(shí)間的測量��。
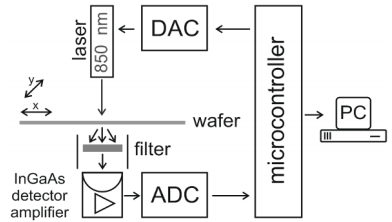 ?
?
圖2
在樣品1的表面����,未進(jìn)行預(yù)處理(圖3a),存在一些局部不均勻的區(qū)域��,主要是由于漿液鋸切的影響��,在20%氫氧化鉀之前的紋理處理中��,去除10m的損傷層�,減少了不均勻性的數(shù)量(圖3b),不含IPA的濃縮加熱氫氧化鉀溶液導(dǎo)致硅表面窒息���。包括用來去除有機(jī)污染的四氯化碳→IPA清洗階段��,導(dǎo)致了紋理化后硅表面的不均勻性的增加(圖3c)���,這可能是由于有機(jī)溶劑從粗糙的切割硅片表面去除的困難���,有機(jī)物的痕跡會影響局部硅蝕刻速率,從而導(dǎo)致紋理形成后的不均勻性(圖4b)��,其中小金字塔沿著大金字塔形成�。這種金字塔大小的偏差導(dǎo)致了不同的光反射率和視覺上的不均勻性����,在濃縮硝酸中燒煮完全去除任何有機(jī)溶劑的痕跡��,并在硅表面的大部分金屬殘留��,導(dǎo)致任何不均勻性幾乎完全消失(圖3d)��。
?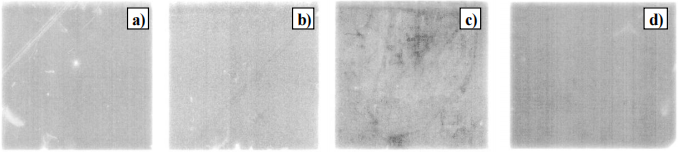
圖3
局部缺陷作為少數(shù)充電器載流子的重組中心�,降低了太陽能電池的效率�����,為了可視化缺陷�����,采用了PL衰減測量的方法�,PL衰減時(shí)間與硅中的少數(shù)載流子壽命直接相關(guān),可用于局部壽命值的估計(jì)����,在使用不同條件下預(yù)處理的硅樣品的壽命測量結(jié)果中,紋理處理后的樣品№1顯示了PL衰變表面分布的最低載流子壽命值和最高的非均勻性,去除10m厚的硅層和隨后的紋理會導(dǎo)致PL衰減均勻性的增加�����,但其絕對值變化不大���,在平面化和紋理化之前,用有機(jī)溶劑進(jìn)行額外的表面清洗階段導(dǎo)致了PL衰減值和總表面均勻性的增加����,PL衰變和硅表面質(zhì)量分別獲得樣品№4初始切割硅初步清洗四氯化碳和IPA溶劑其次是有機(jī)和金屬痕跡去除沸騰硝酸,然后與20%氫氧化鉀���,最后紋理4%KOH+IPA解決方案��。
最后結(jié)果表明���,化學(xué)預(yù)處理對硅表面質(zhì)量和紋理均勻性有很大的影響,在紋理化之前��,切漿鋸硅片應(yīng)在有機(jī)溶劑中清洗�����,以去除有機(jī)污染物的痕跡�����,然后用煮沸的硝酸仔細(xì)清洗�,以溶解金屬污染物��,分解殘留的有機(jī)化合物����,最后用20%氫氧化鉀加熱溶液平滑,所有列出的階段的實(shí)現(xiàn)提供了一個(gè)準(zhǔn)備良好的硅表面���,用于4%氫氧化鉀+IPA溶液中的均勻紋理�����,有效壽命的測量證實(shí)了硅表面下沒有損傷層�����。