
掃碼添加微信����,獲取更多半導(dǎo)體相關(guān)資料
摘要
處理納米級(jí)顆粒污染仍然是半導(dǎo)體器件制造過(guò)程中的主要挑戰(zhàn)之一��。對(duì)于越來(lái)越多的關(guān)鍵處理步驟而言尤其如此�,在這些步驟中,需要去除顆粒物質(zhì)的殘留物而不會(huì)對(duì)敏感器件圖案造成機(jī)械損壞���,同時(shí)實(shí)現(xiàn)盡可能低的基板損失���。如果允許更高的基板損失,則可以采用或多或少純的化學(xué)機(jī)制(例如��,基板蝕刻和剝離導(dǎo)致的顆粒底切)�����。然而�,僅允許在統(tǒng)計(jì)上看到亞埃材料損失,需要將物理力與適當(dāng)?shù)幕瘜W(xué)支持結(jié)合起來(lái)��。在本文中�,我們描述了基于單分散液滴撞擊的顆粒清潔技術(shù)。
介紹
硅晶片上殘留的微粒污染仍然是先進(jìn)半導(dǎo)體制造中產(chǎn)量損失的主要原因之一����。 因此,隨著更小的設(shè)備節(jié)點(diǎn)不斷發(fā)展�,對(duì)控制微粒污染的新技術(shù)和工藝的要求變得越來(lái)越嚴(yán)格。正如《國(guó)際半導(dǎo)體技術(shù)路線圖》(ITRS 2012 更新版)所述,“致命缺陷”尺寸(臨界粒徑)隨著器件的產(chǎn)生而不斷減小�,現(xiàn)在臨界粒徑小于MPU(主處理單元)物理門(mén)長(zhǎng)度。而且�����,顯然��,必須在不對(duì)機(jī)械敏感的設(shè)備結(jié)構(gòu)造成任何結(jié)構(gòu)損壞的情況下實(shí)現(xiàn)高顆粒去除效率 (PRE)�,并且材料損失最小(在亞埃范圍內(nèi)統(tǒng)計(jì)可見(jiàn))。這些良率降低因素的來(lái)源可能是作為先前加工步驟或晶片處理的副產(chǎn)品的落下顆粒����。
顆粒去除基礎(chǔ)
對(duì)顆粒粘附的理解在確定合適的清潔方法中起著關(guān)鍵作用。它會(huì)影響清潔液化學(xué)成分的選擇以及提供物理力以從基材上去除顆粒所需的機(jī)制����。這種粒子-基材-相互作用的強(qiáng)度取決于材料和發(fā)生相互作用的介質(zhì)的物理和化學(xué)特性�����、兩個(gè)物體的幾何形狀及其分離距離�����。顆粒去除與層流或湍流邊界層流的粘性子層內(nèi)近壁顆粒的傳輸有關(guān)���。通過(guò)建模����、數(shù)值模擬和原子力實(shí)驗(yàn)����,對(duì)流體動(dòng)力作用下的粒子粘附和脫離有了深入的了解�。
?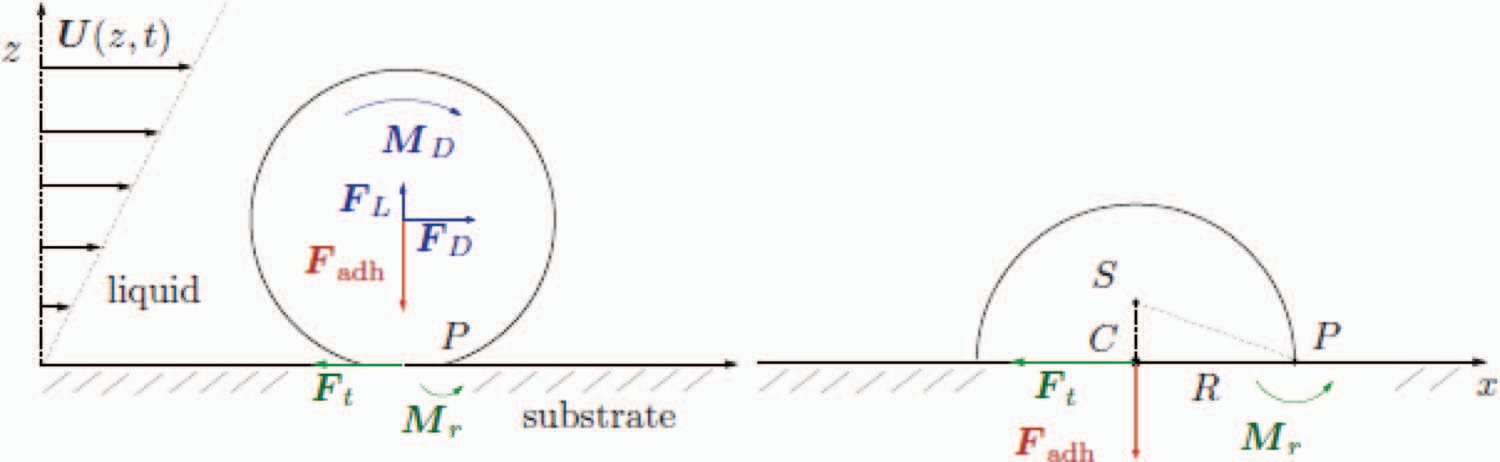
圖1?實(shí)體平面上球體的接觸力學(xué)���。Ft 是切向摩擦力 Mr 、滾動(dòng)阻力�����、Fadh 附著力����、FL 升力、FD 阻力和 MD 相對(duì)于質(zhì)心 S 的流體動(dòng)力阻力����。右側(cè)顯示了粘附在表面上的半球. C表示接觸區(qū)域的中心。相對(duì)于通過(guò) P 的軸會(huì)發(fā)生滾動(dòng)或傾斜����。R 表示粒子的半徑�。
通過(guò)移動(dòng)接觸線去除顆粒
例如從環(huán)境研究中得知微米級(jí)及以下的膠體可以從固體表面分離并通過(guò)緩慢移動(dòng)的氣水界面?zhèn)鬏敗T谶@種情況下����,由于移動(dòng)接觸線(三相邊界)而產(chǎn)生的毛細(xì)作用力顯然可以克服附著力。雖然文獻(xiàn)中已經(jīng)研究了幾個(gè)例子��,但細(xì)節(jié)足夠復(fù)雜�,還沒(méi)有完全理解。這種現(xiàn)象取決于顆粒大小��、接觸線的方向和速度���、液體與顆粒的接觸角等參數(shù)����。
典型的物理清潔技術(shù)基于對(duì)暴露的基材表面施加流體動(dòng)力學(xué)剪切應(yīng)力�,從而對(duì)顆粒施加足夠大的拖曳力以將其去除。然而�,基板上的器件結(jié)構(gòu)也會(huì)受到這種剪切應(yīng)力�����,當(dāng)這種應(yīng)力足夠大時(shí)���,可能會(huì)導(dǎo)致線路損壞���。對(duì)于具有矩形橫截面的線�����,可以表明���,線 σS 底部承受的應(yīng)力與流體動(dòng)力壁剪切應(yīng)力 τS 乘以線的縱橫比的平方 AR 成正比。
文章全部詳情�����,請(qǐng)加華林科納V了解:壹叁叁伍捌零陸肆叁叁叁